

当前选项:所有产品
-

倒装芯片球栅格阵列FCBGA
倒装芯片球栅格阵列FCBGA
▪ 层数——8L 3+2+3▪ 材料——MCL-E-705G+ABF GL102▪ 板厚——0.76mm▪尺寸——50*50 mm▪ 内外层铜厚——17um▪最小线宽/线距——10/10 um▪最小孔径——50um▪ 表面处理——IT+SOP
了解详情 > -

高性能计算GPU
高性能计算GPU
◆ Structure:12L,5+2+5◆ Core: BT / thickness 0.8mm◆ Bulid up : GX92/ thickness 25μm
了解详情 > -

应用处理基带芯片AP/FCCSP
应用处理基带芯片AP/FCCSP
◆ Structure : 2L,Total thickness170 μm, core thickness 100μm;◆ MSAP process,L/S=20/20μm◆ 75μm laser dirlled “X” hole ,copper filled.Bonding finger Pitch: 95μm(50/40μm)BOL Pitch: 55μm(25/30μm)◆ Surface finish:Soft Ni/Au+OSP +Etch-back
了解详情 > -

应用处理基带芯片AP/FCCSP
应用处理基带芯片AP/FCCSP
◆ Structure : 6L, 2+2+2,Total thickness 400 μm, core thickness 150μm;Inner layer: 75μm laser dirlled“X” hole ,copper filled. Outer layer:60μmlaser blind via.◆ Fine line: inner layerMSAP process,L/S=15/15 μm.◆ AUS SR1/thickness 15+/-7μm,SRO=105μm,SM shift tolerance≤15...
了解详情 > -

存储类芯片LPDDR
存储类芯片LPDDR
◆ Structure:3L Coreless, Total thickness:130μm;◆ MSAP process,BF Pitch/Width min /Space min :65/35/15μm;◆ Warpage≤2mm(before reflow);◆ Surface finish: AFOP(TOP:Ni/Au,BTM: OSP)
了解详情 > -

存储类芯片SSD
存储类芯片SSD
◆ Structure: 2L,Total thickness:100 μm min;Mechanical Drilling,Filled Via with SM;Laser Drilling,Filled Via with Copper, dimple≤5μm;◆ Tenting process,L/S≥35/35um;MSAP process,L/S≤25/25μm;◆ SM colour: Green or Black matte /thickness 20+/-7μm,SM Flatness≤7μm;◆ Surface fini...
了解详情 > -
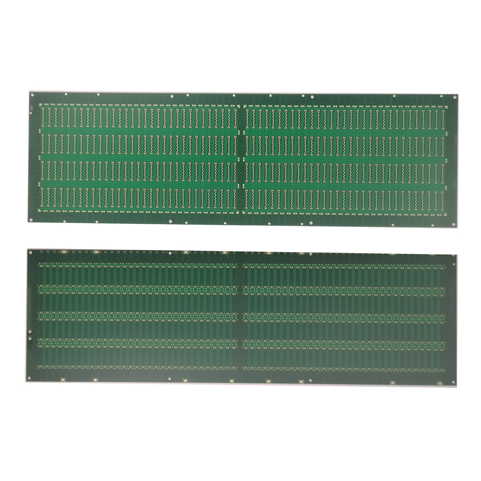
指纹模组Touch Fingerprint
指纹模组Touch Fingerprint
◆ Structure: 2L,Substrate thickness tolerance±15μm;Mechanical Drilling,Filled Via with SM or resin;◆ Tenting process,L/S≥35/35μm;◆ AUS320/25±7μm,SM Flatness≤7um;◆ Surface finish: Soft Ni/Au +Etch-back
了解详情 > -

射频模组RF
射频模组RF
◆ Structure: 4L,1+2+1,Total thickness:180μm min;◆ Layer alignment: blind via ring width 25μm,Adjacentlayer shift≤25μm,Random layer shift≤40μm◆ MSAP process,trace width tolerance ±5μm ;◆ Surface finish: Thin ENEPIG ( Ni thickness 0.3~0.5μm)
了解详情 > -

高阶HDI板12Anylayer
高阶HDI板12Anylayer
▪ Layers:12L ▪ Board thickness:0.8mm ▪ Material:EM-370 ▪ Min Width/Spacing:60/60um ▪ Surface treament:ENIG+OSP
了解详情 > -

高阶HDI板16层3阶
高阶HDI板16层3阶
▪ Layers -- 16Layer ▪ Material -- PanasonicR-5775 ▪ Thickness --2mm ▪ Inner copper -- HOZ ▪ Min line width/spacing -- 2/2mil ▪ Min Aperture --0.1mm ▪ Surface Treament- ENIG ▪ Application --Communication Equipmet
了解详情 > -

高阶HDI板24层2阶
高阶HDI板24层2阶
▪ 层数:24L▪ 材料:FR-4(Tg180) VT-47▪ 板厚:2.59+/-0.26mm▪ 最小线宽/线距:3.5/5.0mil▪ 最小孔径:0.25mm▪ 表面处理:沉金
了解详情 > -

高多层板10层光模块
高多层板10层光模块
▪ 层数:10L▪ 产品型号:400Gbps QSFP-DD▪ 材料:M6(R-5775)▪ 成品厚度公差:金手指区1.0士0.075mm▪ 插头外形公差:士0.05mm▪ 填孔凹陷:<15μm▪ 表面处理:沉镍钯金+电镀硬金▪ 散热设计:埋铜块
了解详情 >

